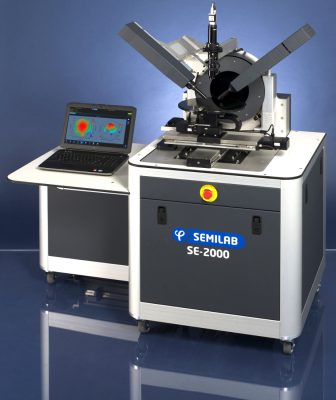
エリプソメーターとは
エリプソメーターは、サンプル表面から反射された光の偏光の状態変化(ΨΔ)を測定することにより、サンプル(薄膜、基盤)の膜厚値、屈折率、消衰係数を求める光学測定装置です。単層膜から多層膜の各層の膜厚値と光学定数(屈折率、消衰係数)を非接触・非破壊で測定することが可能です。
膜厚値は、サブナノメートルから数十マイクロメートルの範囲で精度良い測定ができ、一般的な酸化膜、窒化膜、フォトレジストを含む半導体材料からディスプレイ用の有機膜や透明導電膜、また金属薄膜や表面粗さ測定まで幅広いアプリケーションでご使用頂いています。
分光エリプソメーターSE-2000とは
エリプソメーターのパイオニアであるSopra時代(1983年創業)から、セミラボでは数多くの分光エリプソメーターを販売してきました。新製品エリプソメーターSE-2000では、弊社ベストセラーである分光エリプソメーター旧モデルで培われた経験と技術を継承しつつ、数多くのお客様の声を元に改善を行い、その結果、従来機以上の測定精度、操作性、安定性を実現しました。回転補償子型による測定精度の向上に加えて、使い勝手の良い解析ソフトウェアと豊富なデーターベースで、研究開発からインライン生産品質管理など様々な用途でご使用頂いています。
回転補償子型 分光エリプソメーター
エリプソメーターには様々な測定方式が存在していますが、分光エリプソメーターSE-2000では、高精度測定のため最新の回転補償子型を採用しています。補償子を使用していない様々な測定方式では、測定データΔ=0付近で避けることが出来ない測定誤差が生じてしまうために結果として正しくない解析結果を導いてしまうことが起こりえますが、回転補償子型では、Δ=0付近も高精度で測定が可能なため、正確な解析結果が得られます。このため、ユーザーは測定方式による誤差要因を心配することなく、安心して装置をご使用頂けます。
深紫外から中赤外のスペクトル範囲をカバー
分光エリプソメーターSE-2000では、オプションのFTIRエリプソメーターヘッドを可視アーム付属の同じゴニオメーターに搭載する独自レイアウトにより、単一装置で深紫外(193nm)から中赤外(25μm)までの最も広いスペクトル範囲をカバーできます。
高速測定モードと高分解能モード
装置構成としては、スペクトログラフとCCD検出器アレイを用いた高速測定モードと、スペクトロメーターと単一点検出器(PMT)を用いた高分解能モード、また両方のモードを同じ装置で選択して頂くことも可能です。
最新の解析ソフトウェア
分光エリプソメーターSE-2000には、コンポーネントを交換可能なセミラボの新型高性能電子機器が搭載されており、新世代の動作・分析ソフトウェア(SAM/SEA)で動作します。最新の解析専用ソフトウェアでは、Sopra社時代からの豊富なNK値と光学モデルのデータベースが搭載されていることに加えて、最新のGUIにより視覚的にパラメーター初期値の最適化が可能になり、複数の光学モデルを組み合わせることで、困難な解析にも容易にアプローチが可能になりました。
分光エリプソメーターSE-2000の特長
- 多数の販売実績
- 回転補償子型による高精度測定
- 高分解能アレイ検出器による高速測定(数秒/ポイント)
- 光電子増倍管PMTによる高精度測定
- 裏面反射影響除去機能
- 操作性に優れたソフトウェア
- 豊富なデータベース
- 様々なオプションによる拡張性
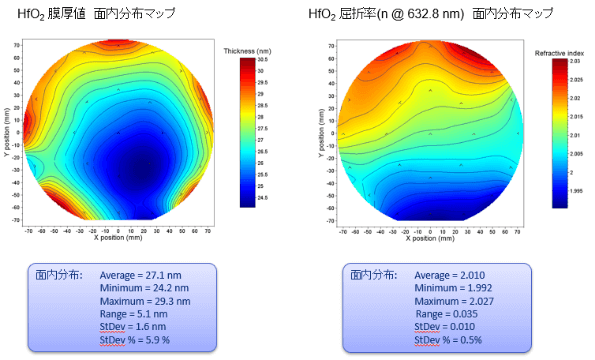

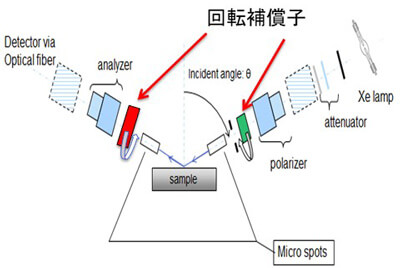

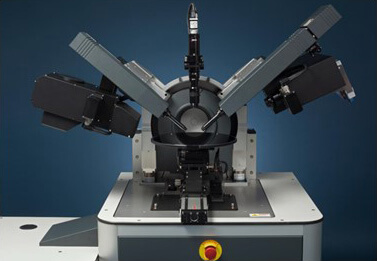

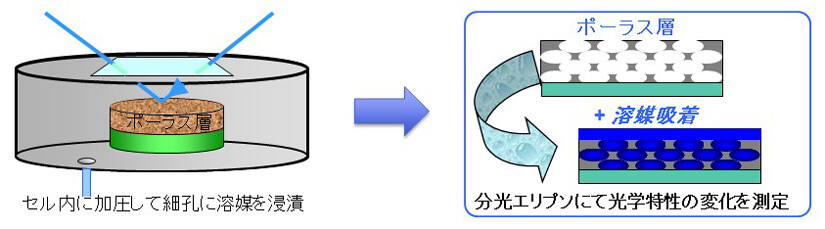
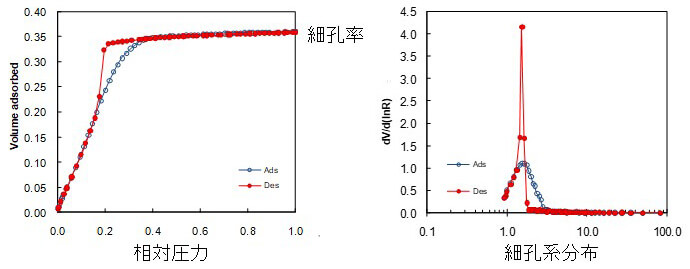

 4探針法との相関曲線
4探針法との相関曲線
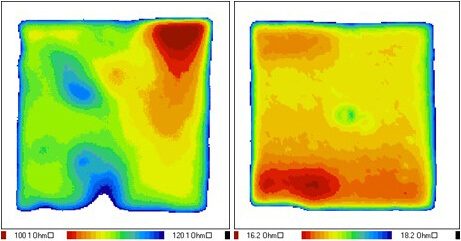 渦電流法にての非接触シート抵抗マッピング例
渦電流法にての非接触シート抵抗マッピング例